QR-kod

Produkter
Kontakta oss


Fax
+86-579-87223657

E-post

Adress
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Kiselkarbid är ett av de ideala materialen för att göra hög temperatur, högfrekvent, högeffekt och högspänningsanordningar. För att förbättra produktionseffektiviteten och minska kostnaderna är beredningen av storstor kiselkarbidunderlag en viktig utvecklingsriktning. Siktar på processkraven för8-tums kiselkarbid (sic) enkelkristalltillväxt, tillväxtmekanismen för kiselkarbidens fysiska ångtransport (PVT) -metod analyserades, värmesystemet (TAC -guidring, TAC -belagd degel,TAC -belagda ringar, TAC-belagd platta, TAC-belagd trepetallring, TAC-belagd tre-petal Crucible, TAC-belagd hållare, porös grafit, mjuk filt, styv filt Sic-belagd kristalltillväxt Susceptor och annanSIC enstaka kristalltillväxtprocess reservdelartillhandahålls av Vetek Semiconductor), Crucible Rotation and Process Parameter Control Technology of Silicon Carbide Single Crystal Growth Furnace studerades och 8-tums kristaller framställdes framgångsrikt och odlades genom termisk fältsimuleringsanalys och processexperiment.
Introduktion
Kiselkarbid (SIC) är en typisk representant för tredje generationens halvledarmaterial. Den har prestandamentor som större bandgapbredd, högre nedbrytning av elektriskt fält och högre värmeledningsförmåga. Det fungerar bra inom högtemperatur, högtryck och högfrekvensfält och har blivit en av de viktigaste utvecklingsanvisningarna inom området halvledarmaterial. För närvarande använder den industriella tillväxten av kiselkarbidkristaller främst fysisk ångtransport (PVT), vilket involverar komplex multi-fysiska fältkopplingsproblem i multifas, multikomponent, multipel värme- och massöverföring och magneto-elektrisk värmeflödesinteraktion. Därför är utformningen av PVT -tillväxtsystemet svår och processparametermätningen och kontrollen underkristalltillväxtprocessär svårt, vilket resulterar i svårigheten att kontrollera kvalitetsdefekterna hos de vuxna kiselkarbidkristallerna och den lilla kristallstorleken, så att kostnaden för anordningar med kiselkarbid eftersom substratet förblir höga.
Tillverkningsutrustning för kiselkarbid är grunden för kiselkarbidteknik och industriell utveckling. Den tekniska nivån, processförmågan och oberoende garanti för kiselkarbid-enstaka tillväxtugn är nyckeln till utvecklingen av kiselkarbidmaterial i riktning mot stor storlek och hög utbyte, och är också de viktigaste faktorerna som driver tredje generationens halvledarindustri att utvecklas i riktning mot låg kostnad och storskalig. I halvledaranordningar med kiselkarbid enkristall som substrat står värdet på substratet för den största andelen, cirka 50%. Utvecklingen av storstor högkvalitativ kiselkarbidkristalltillväxtutrustning, förbättring av utbytet och tillväxthastigheten för kiselkarbid-enstaka kristallsubstrat och att minska produktionskostnaderna är av viktig betydelse för tillämpningen av relaterade anordningar. För att öka produktionen av produktionskapaciteten och ytterligare minska den genomsnittliga kostnaden för kiselkarbidanordningar är utvidgningen av storleken på kiselkarbidunderlag ett av de viktiga sätten. För närvarande är den internationella mainstream -kiselkarbidunderlagsstorleken 6 tum och den har snabbt gått till 8 tum.
De viktigaste teknologierna som måste lösas i utvecklingen av 8-tums kiselkarbid-enstaka tillväxtugnar inkluderar: (1) Utformning av storstor termisk fältstruktur för att erhålla en mindre radiell temperaturgradient och en större longitudinell temperaturgradient som är lämplig för tillväxten av 8-tums kiselkarbidkristaller. (2) Storlek av de ingångsrotation och spollyftning och sänkning av rörelsemekanism, så att degeln roterar under kristalltillväxtprocessen och rör sig relativt spolen enligt processkraven för att säkerställa konsistensen av 8-tums kristall och underlätta tillväxt och tjocklek. (3) Automatisk kontroll av processparametrar under dynamiska förhållanden som uppfyller behoven hos högkvalitativ tillväxtprocess.
1 Pvt Crystal Growth Mechanism
PVT -metoden är att framställa kiselkarbid -enstaka kristaller genom att placera SIC -källan längst ner i en cylindrisk tät grafit -degel, och SiC -frökristallen placeras nära degelskyddet. Degeln värms upp till 2 300 ~ 2 400 ℃ genom radiofrekvensinduktion eller motstånd och isoleras av grafitfilt ellerporös grafit. De viktigaste ämnena som transporteras från SiC -källan till frökristallen är Si, Si2C -molekyler och Sic2. Temperaturen vid frökristallen styrs för att vara något lägre än den vid den nedre mikropulver, och en axiell temperaturgradient bildas i degeln. Såsom visas i figur 1 sublimerar kiselkarbidmikro-powder-sublimaten vid hög temperatur för att bilda reaktionsgaser från olika gasfaskomponenter, som når frökristallen med en lägre temperatur under drivkraften för temperaturgradienten och kristalliserar den för att bilda en cylindrisk kiselkarbidingöt.
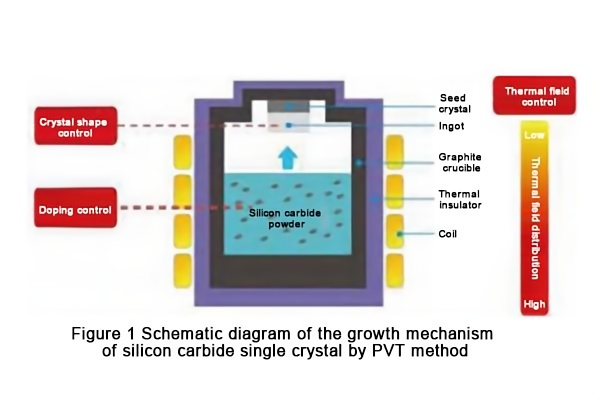
De viktigaste kemiska reaktionerna för PVT -tillväxt är:
Sic (s) ⇌ si (g)+c (s)
2sic ⇌ och2C (g)+c (s)
2SIC ⇌ SIC2 (G)+SI (L, G)
Sic (s) ⇌ sic (g)
Egenskaperna för PVT -tillväxt av SIC -enstaka kristaller är:
1) Det finns två gas-fasta gränssnitt: det ena är gas-sic pulvergränssnittet, och det andra är gaskristallgränssnittet.
2) gasfasen består av två typer av ämnen: en är de inerta molekylerna som introduceras i systemet; den andra är gasfaskomponenten Simcn som produceras genom nedbrytning och sublimering avSicpulver. Gasfaskomponenterna SIMCN interagerar med varandra, och en del av de så kallade kristallina gasfaskomponenterna SIMCN som uppfyller kraven i kristallisationsprocessen kommer att växa till SIC-kristallen.
3) I det fasta kiselkarbidpulvret kommer fastfasreaktioner att inträffa mellan partiklar som inte har sublimerat, inklusive vissa partiklar som bildar porösa keramiska kroppar genom sintring, vissa partiklar som bildar korn med en viss partikelstorlek och kristallografisk morfologi genom kristallisationsreaktioner, och vissa kiselkolarbidespartiklar omvandlar till karbon-partiklar eller karbonpartiklar som non-stochichi genom kristallisationsreaktioner, och vissa kiselkarbidpartiklar omvandlar till kol-rika partiklar eller karbonpartiklar som non-stochichi genom kristallisationsreaktioner, och vissa kiselkarbidpartiklar omvandlar till karbon-partiklar eller karbonpartiklar för att non-sto-decrichi.
4) Under kristalltillväxtprocessen kommer tvåfasförändringar att inträffa: en är att de fasta kiselkarbidpulverpartiklarna omvandlas till gasfaskomponenter SIMCN genom icke-stökiometrisk sönderdelning och sublimering, och den andra är att gasfaskomponenterna SIMCN omvandlas till gitterpartiklar genom kristallisation.
2 Utrustningens design
Såsom visas i figur 2 inkluderar kiselkarbid -enstaka ugn för en kristalltillväxt huvudsakligen: övre täckmontering, kammarmontering, värmesystem, degelrotationsmekanism, lägre täckmekanism och elektriska styrsystem.

2.1 Uppvärmningssystem
Såsom visas i figur 3 antar värmesystemet induktionsuppvärmning och består av en induktionsspole, agrafitgel, ett isoleringsskikt (styvt filt, mjuk filt), etc. När den medelfrekvensväxlande strömmen passerar genom induktionsspolen med flera svängningar som omger utsidan av grafitkärnan, kommer ett inducerat magnetfält av samma frekvens att bildas i grafitkärnan, vilket genererar en inducerad elektromotivkraft. Eftersom grafitmaterialet med hög renhet har god konduktivitet genereras en inducerad ström på degelväggen och bildar en virvelström. Under verkan av Lorentz -styrkan kommer den inducerade strömmen så småningom att konvergera på de kälvets yttervägg (dvs hudeffekten) och gradvis försvaga längs den radiella riktningen. På grund av förekomsten av virvelströmmar genereras Joule -värmen på de kudde väggen och blir värmekällan för tillväxtsystemet. Storleken och fördelningen av Joule -värme bestämmer direkt temperaturfältet i degeln, vilket i sin tur påverkar kristallens tillväxt.
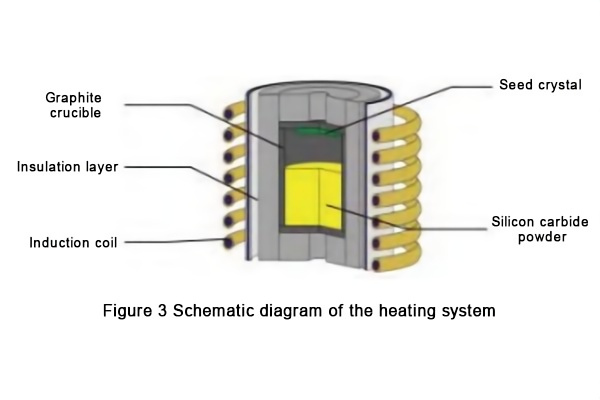
Såsom visas i figur 4 är induktionsspolen en viktig del av värmesystemet. Den antar två uppsättningar av oberoende spirstrukturer och är utrustad med övre respektive nedre precisionsrörelsemekanismer. Det mesta av den elektriska värmeförlusten av hela värmesystemet bärs av spolen och tvingad kylning måste utföras. Spolen är lindad med ett kopparrör och kyls med vatten inuti. Frekvensområdet för den inducerade strömmen är 8 ~ 12 kHz. Frekvensen för induktionsuppvärmningen bestämmer penetrationsdjupet för det elektromagnetiska fältet i grafitkärnan. Spolrörelsemekanismen använder en motordriven skruvparmekanism. Induktionsspolen samarbetar med induktionskraftförsörjningen för att värma den inre grafiten degeln för att uppnå sublimeringen av pulvret. Samtidigt styrs kraften och relativa positionen för de två uppsättningarna av spolar för att göra temperaturen vid frökristallen lägre än den vid den nedre mikropulveren, bildar en axiell temperaturgradient mellan frökristallen och pulvret i degeln och bildar en rimlig radiell temperaturgradient vid kiselkarbidkristallen.

2.2 Crucible Rotation Mechanism
Under tillväxten av storstorakiselkarbid enstaka kristaller, degeln i vakuummiljön i kaviteten hålls roterande enligt processkraven, och gradientens termiska fält och lågtryckstillståndet i kaviteten måste hållas stabilt. Såsom visas i figur 5 används ett motordrivet växelpar för att uppnå stabil rotation av degeln. En magnetisk vätsketätningsstruktur används för att uppnå dynamisk tätning av den roterande axeln. Den magnetiska vätsketätningen använder en roterande magnetfältkrets som bildas mellan magneten, den magnetiska polskon och den magnetiska hylsan för att helt adsorbera magnetvätskan mellan polskospetsen och hylsan för att bilda en O-ringliknande vätskring, vilket helt blockerar klyftan för att uppnå syftet med att försegla. När rotationsrörelsen överförs från atmosfären till vakuumkammaren, används den flytande O-ring-dynamiska tätningsanordningen för att övervinna nackdelarna med enkel slitage och låg livslängd i fast tätning, och den flytande magnetiska vätskan kan fylla hela förseglade utrymmet, därmed blockera alla kanaler som kan läcka luft och dra noll läckage i de två processerna och stoppa rörelsen och att blockera. Det magnetiska vätskan och degelstödet använder en vattenkylningsstruktur för att säkerställa hög temperaturens användbarhet för magnetvätskan och degelstödet och uppnå stabiliteten i det termiska fälttillståndet.

2.3 Lyftmekanism för lägre täckning
Den nedre täckmekanismen består av en drivmotor, en kulskruv, en linjär guide, en lyftfäste, ett ugnsskydd och en ugnsskåp. Motorn driver ugnsskyddet anslutet till skruvguideparet genom en reducerare för att inse upp- och ner -rörelsen på det nedre locket.
Den nedre täckningsmekanismen underlättar placering och avlägsnande av stora storlekar, och ännu viktigare, säkerställer förseglingens tillförlitlighet för det nedre ugnsskyddet. Under hela processen har kammaren tryckförändringssteg såsom vakuum, högt tryck och lågt tryck. Komprimering och tätningsläge för det nedre locket påverkar direkt processens tillförlitlighet. När tätningen misslyckas under hög temperatur kommer hela processen att skrotas. Genom motorens servokontroll och begränsa anordningen styrs tätheten i den nedre täckenheten och kammaren för att uppnå det bästa läget för kompression och tätning av ugnskammarens tätningsring för att säkerställa stabiliteten i processtrycket, såsom visas i figur 6.
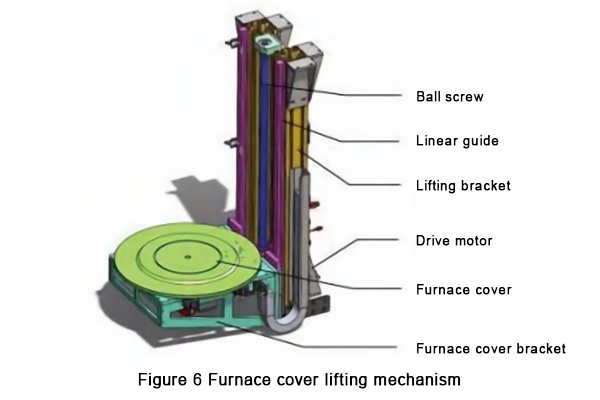
2.4 Elektriskt styrsystem
Under tillväxten av kiselkarbidkristaller måste det elektriska styrsystemet noggrant kontrollera olika processparametrar, främst inklusive spolpositionens höjd, degelrotationshastighet, värmekraft och temperatur, olika specialgasintagflöde och öppningen av proportionell ventil.
Såsom visas i figur 7 använder styrsystemet en programmerbar styrenhet som en server, som är ansluten till servodrivrutinen genom bussen för att inse rörelsekontrollen av spolen och degeln; Den är ansluten till temperaturkontrollen och flödeskontrollen genom standardmobusrtu för att realisera realtidskontroll av temperatur, tryck och specialprocessgasflöde. Den skapar kommunikation med konfigurationsprogramvaran via Ethernet, utbyter systeminformation i realtid och visar olika processparameterinformation på värddatorn. Operatörer, processpersonal och chefer utbyter information med kontrollsystemet genom human-maskingränssnittet.

Kontrollsystemet utför all fältdatainsamling, analys av driftsstatusen för alla ställdon och det logiska förhållandet mellan mekanismerna. Den programmerbara styrenheten får instruktionerna från värddatorn och slutför kontrollen av varje ställdon för systemet. Exekverings- och säkerhetsstrategin för den automatiska processmenyn körs alla av den programmerbara styrenheten. Stabiliteten för den programmerbara styrenheten säkerställer stabilitet och säkerhets tillförlitlighet för processmenyoperationen.
Den övre konfigurationen upprätthåller datautbyte med den programmerbara styrenheten i realtid och visar fältdata. Den är utrustad med driftsgränssnitt som värmekontroll, tryckkontroll, gaskretsstyrning och motorstyrning och inställningsvärdena för olika parametrar kan modifieras på gränssnittet. Realtidsövervakning av larmparametrar, tillhandahåller skärmlarmvisning, registrering av tiden och detaljerade data om larmhändelse och återhämtning. Inspelning av realtid av all processdata, skärmdriftsinnehåll och driftstid. Fusionskontrollen av olika processparametrar realiseras genom den underliggande koden i den programmerbara styrenheten, och maximalt 100 processsteg kan realiseras. Varje steg innehåller mer än ett dussin processparametrar såsom processdrift, målkraft, måltryck, argonflöde, kväveflöde, väteflöde, degelposition och degelhastighet.
3 Termisk fältsimuleringsanalys
Den termiska fältsimuleringsanalysmodellen är etablerad. Figur 8 är temperaturmolnkartan i degeln tillväxtkammaren. För att säkerställa tillväxttemperaturområdet för 4H-SIC-enkristall beräknas frökristallens mitttemperatur till 2200 ℃ och kantemperaturen är 2205,4 ℃. För närvarande är centrumtemperaturen för den kudde toppen 2167,5 ℃, och den högsta temperaturen i pulverområdet (sidan nedåt) är 2274,4 ℃, och bildar en axiell temperaturgradient.

Den radiella gradientfördelningen av kristallen visas i figur 9. Den lägre sidotemperaturgradienten för frökristallytan kan effektivt förbättra kristalltillväxtformen. Den nuvarande beräknade initiala temperaturskillnaden är 5,4 ℃, och den totala formen är nästan platt och något konvex, vilket kan uppfylla den radiella temperaturkontrollnoggrannheten och enhetliga kraven på frökristallytan.

Temperaturskillnadskurvan mellan råmaterialytan och frökristallytan visas i figur 10. Mentertemperaturen på materialytan är 2210 ℃, och en longitudinell temperaturgradient på 1 ℃/cm bildas mellan materialytan och frökristallytan, som ligger inom ett rimligt intervall.
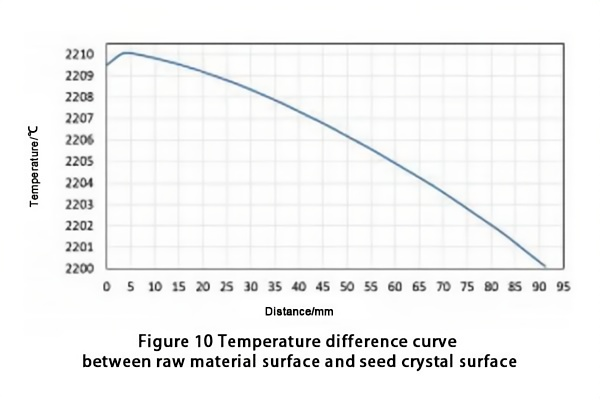
Den uppskattade tillväxthastigheten visas i figur 11. För snabb tillväxt kan öka sannolikheten för defekter såsom polymorfism och dislokation. Den nuvarande uppskattade tillväxttakten är nära 0,1 mm/h, vilket ligger inom ett rimligt intervall.

Genom termisk fältsimuleringsanalys och beräkning har det visat sig att mittens temperatur och kanttemperatur för frökristallen uppfyller den radiella temperaturgradienten i kristallen på 8 tum. Samtidigt bildar de översta och botten av degeln en axiell temperaturgradient som är lämplig för kristallens längd och tjocklek. Den nuvarande uppvärmningsmetoden för tillväxtsystemet kan uppfylla tillväxten av 8-tums enkelkristaller.
4 experimentella test
Med dettakiselkarbid enkristalltillväxtugn, baserat på temperaturgradienten för den termiska fältsimuleringen, genom att justera parametrarna såsom den kudde topptemperaturen, kavitetstrycket, degelrotationshastigheten och den relativa positionen för de övre och nedre spolarna erhölls, en kiselkarbidkristalltest genomfördes och en 8-tums kiselkarbidkristall erhölls (såsom visas i figur 12).

5 Slutsats
De viktigaste teknologierna för tillväxt av 8-tums kiselkarbid enstaka kristaller, såsom gradient termisk fält, degelrörelsemekanism och automatisk kontroll av processparametrar, studerades. Det termiska fältet i degeltillväxtkammaren simulerades och analyserades för att erhålla den ideala temperaturgradienten. Efter testning kan metoden för induktion av dubbelspolar möta tillväxten av stor storlekkiselkarbidkristaller. Forskningen och utvecklingen av denna teknik tillhandahåller utrustningsteknologi för att erhålla 8-tums karbidkristaller och tillhandahåller utrustningens grund för övergången av kiselkarbidindustrialisering från 6 tum till 8 tum, vilket förbättrar tillväxteffektiviteten hos kiselkarbidmaterial och minskar kostnaderna.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alla rättigheter reserverade.
Links | Sitemap | RSS | XML | Sekretesspolicy |
