QR-kod

Produkter
Kontakta oss


Fax
+86-579-87223657

E-post

Adress
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Etsningteknik är ett av nyckelstegen i halvledartillverkningsprocessen, som används för att ta bort specifika material från skivan för att bilda ett kretsmönster. Men under torretsningsprocessen stöter ingenjörer ofta på problem som belastningseffekt, mikrospåreffekt och laddningseffekt, som direkt påverkar kvaliteten och prestanda hos slutprodukten.
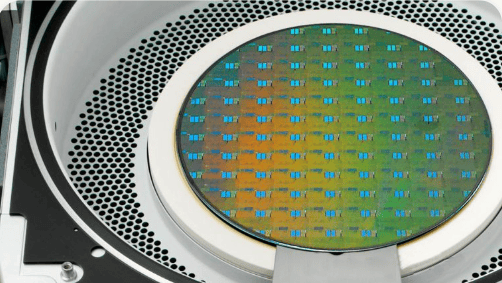
Lastningseffekten avser fenomenet att när etsningsområdet ökar eller etsningsdjupet ökar under torr etsning minskar etsningshastigheten eller etsningen är ojämn på grund av otillräcklig tillförsel av reaktiv plasma. Denna effekt är vanligtvis relaterad till egenskaperna hos etsningssystemet, såsom plasmatäthet och enhetlighet, vakuumgrad, etc., och är allmänt närvarande i olika reaktiva jonetsning.
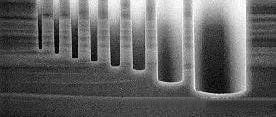
•Förbättra plasmadensitet och enhetlighet: Genom att optimera utformningen av plasmakällan, såsom att använda effektivare RF -effekt eller magnetronsputningsteknik, kan en högre densitet och mer jämnt fördelad plasma genereras.
•Justera sammansättningen av den reaktiva gasen: Att lägga till en lämplig mängd extra gas till den reaktiva gasen kan förbättra plasmans enhetlighet och främja effektivt urladdning av etsningsbiprodukter.
•Optimera vakuumsystemet: Förbättring av pumphastigheten och effektiviteten hos vakuumpumpen kan bidra till att minska uppehållstiden för etsande biprodukter i kammaren, och därigenom minska belastningseffekten.
•Designa en rimlig fotolitografisk layout: Vid design av fotolitografilayouten bör mönstrets densitet beaktas för att undvika övertäta arrangemang i lokala områden för att minska påverkan av belastningseffekten.
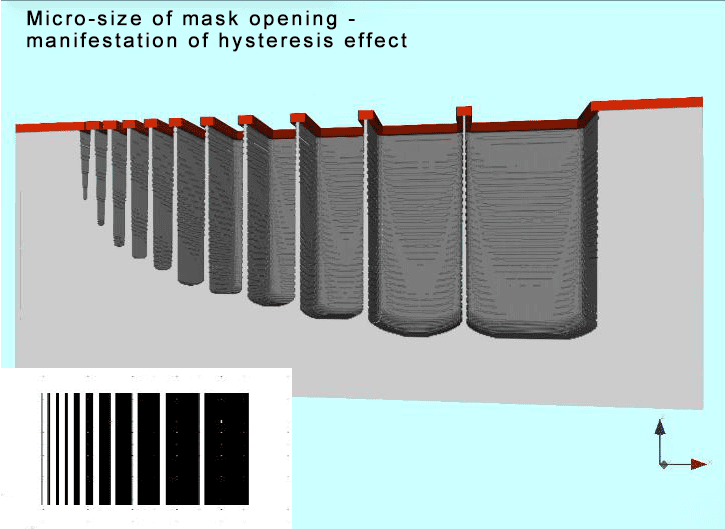
Den mikrogrenande effekten hänvisar till fenomenet som under etsningsprocessen, på grund av de högenergipartiklar som träffar etsningsytan i en lutande vinkel, är etsningshastigheten nära sidoväggen högre än i det centrala området, vilket resulterar i icke -Vertiska kameror på sidoväggen. Detta fenomen är nära besläktat med vinkeln på infallande partiklar och sidoväggens lutning.
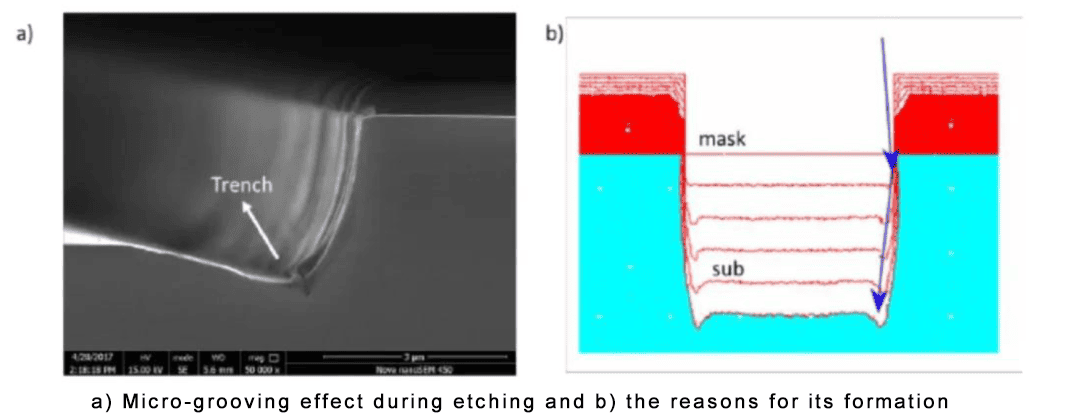
•Öka RF -kraften: Korrekt öka RF -effekten kan öka energin i infallande partiklar, vilket gör att de kan bombardera målytan mer vertikalt, vilket minskar etsningshastighetsskillnaden för sidoväggen.
•Välj rätt etsningsmaskmaterial: Vissa material kan bättre motstå laddningseffekten och minska den mikroavgrenande effekten som förvärras av ackumulering av negativ laddning på masken.
•Optimera etsningsförhållandena: Genom att finjustera parametrar som temperatur och tryck under etsningsprocessen kan etsningens selektivitet och enhetlighet kontrolleras effektivt.
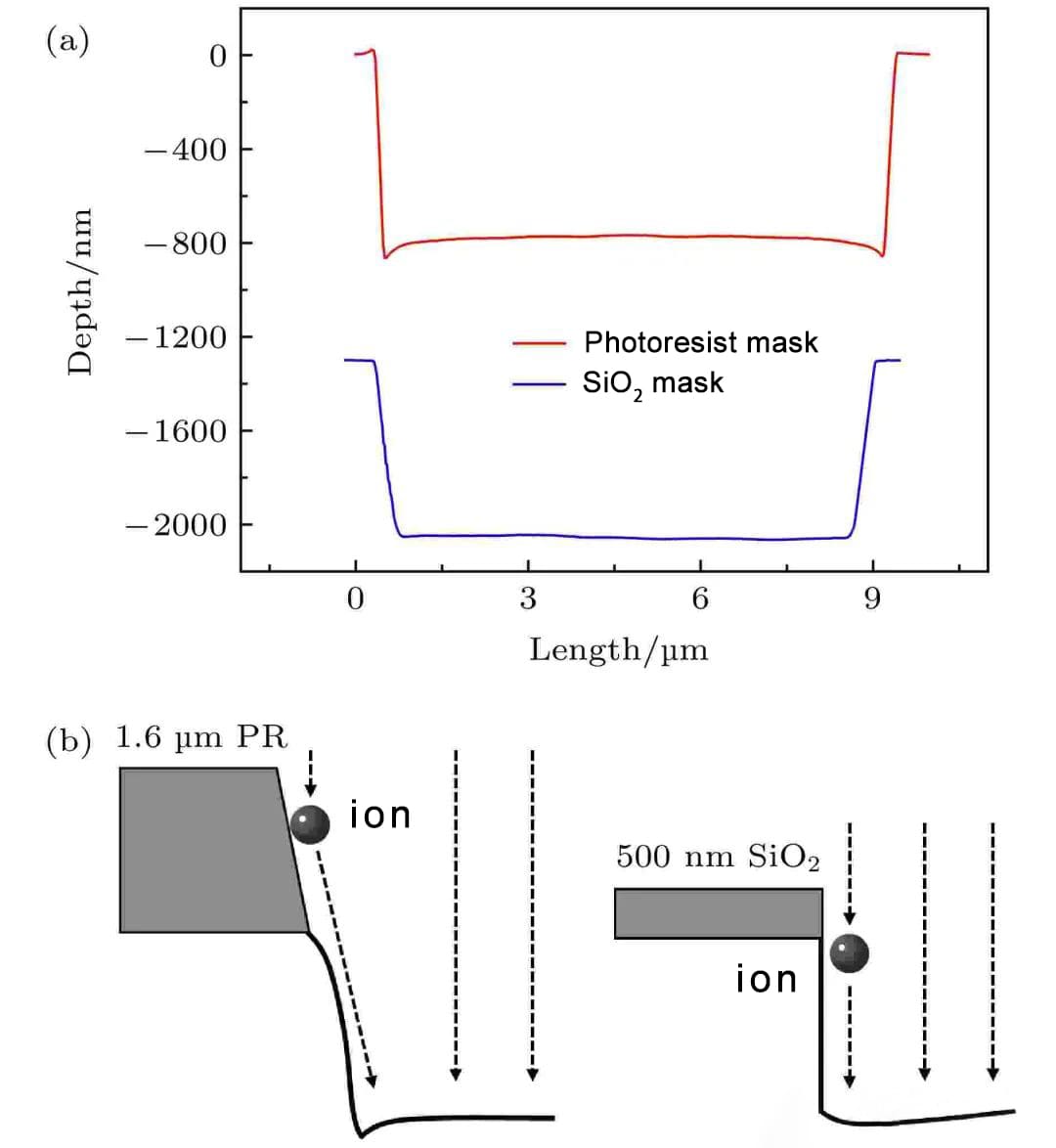
Laddningseffekten orsakas av etsmaskens isolerande egenskaper. När elektronerna i plasman inte kan fly snabbt kommer de att samlas på maskytan för att bilda ett lokalt elektriskt fält, störa de infallande partiklarnas väg och påverka etsningens anisotropi, speciellt vid etsning av fina strukturer.
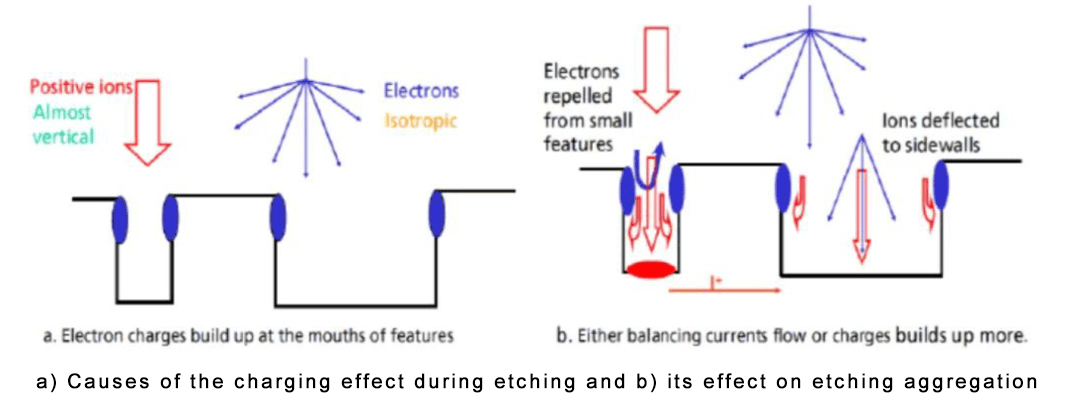
• Välj lämpliga etsningsmaskmaterial: Vissa specialbehandlade material eller ledande maskskikt kan effektivt minska aggregationen av elektroner.
•Implementera intermittent etsning: Genom att periodiskt avbryta etsningsprocessen och ge elektroner tillräckligt med tid att fly kan laddningseffekten minskas avsevärt.
•Justera etsningsmiljön: Ändring av gassammansättning, tryck och andra förhållanden i etsningsmiljön kan bidra till att förbättra plasmans stabilitet och minska förekomsten av laddningseffekten.
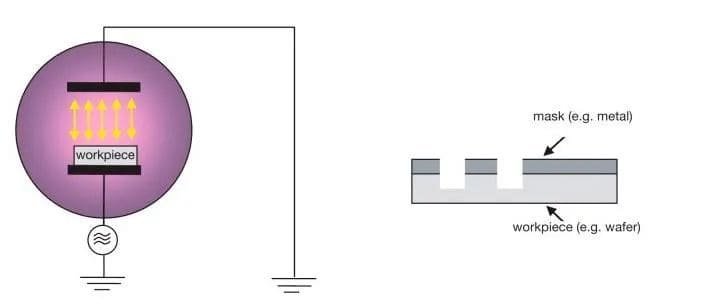



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alla rättigheter reserverade.
Links | Sitemap | RSS | XML | Sekretesspolicy |
