QR-kod

Produkter
Kontakta oss


Fax
+86-579-87223657

E-post

Adress
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Kemisk mekanisk polering (CMP) tar bort överflödigt material och ytdefekter genom den kombinerade verkan av kemiska reaktioner och mekanisk nötning. Det är en nyckelprocess för att uppnå global planarisering av skivans yta och är oumbärlig för flerskiktskopparkopplingar och lågk-dielektriska strukturer. Vid praktisk tillverkning är CMP inte en perfekt enhetlig borttagningsprocess; det ger upphov till typiska mönsterberoende defekter, bland vilka diskning och erosion är de mest framträdande. Dessa defekter påverkar direkt geometrin hos sammankopplingsskikten och deras elektriska egenskaper.
Dishing hänvisar till överdrivet avlägsnande av relativt mjuka ledande material (som koppar) under CMP, vilket leder till en skålformad konkav profil inuti en enda metalllinje eller ett stort metallområde. I tvärsnitt ligger metalllinjens mitt lägre än dess två kanter och den omgivande dielektriska ytan. Detta fenomen observeras ofta i breda linjer, kuddar eller metallområden av blocktyp. Dess formningsmekanism är huvudsakligen relaterad till skillnader i materialhårdhet och deformation av polerplattan över breda metalldetaljer: mjuka metaller är känsligare för de kemiska komponenterna och slipmedlen i slammet, och det lokala kontakttrycket på dynan ökar på breda delar, vilket gör att borttagningshastigheten i metallens mitt överstiger den vid kanterna. Som ett resultat ökar diskdjupet vanligtvis med linjebredden och tiden för överpolering.
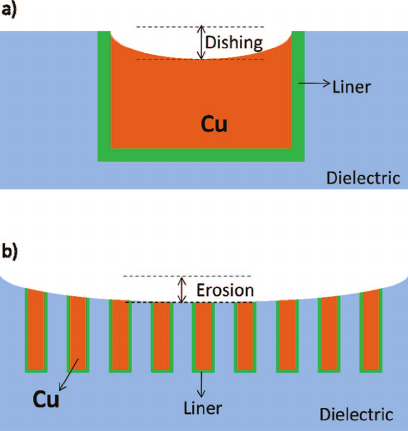
Erosion kännetecknas av att den totala ythöjden i områden med hög mönsterdensitet (såsom täta metalllinjer eller områden med tät dummyfyllning) är lägre än den i omgivande glesa områden efter CMP. I grund och botten är det ett mönsterdensitetsdrivet överborttagning av material på regionnivå. I täta områden ger metall och dielektrikum tillsammans en större effektiv kontaktyta, och den mekaniska friktionen och kemiska verkan av dynan och slurryn är starkare. Följaktligen är den genomsnittliga avlägsningshastigheten för både metall och dielektrikum högre än i lågdensitetsområden. När polering och överpolering fortskrider blir metall-dielektriska stapeln i täta områden tunnare som helhet, vilket bildar ett mätbart höjdsteg, och graden av erosion ökar med lokal mönstertäthet och processbelastning.
Ur perspektivet av enhets- och processprestanda har diskning och erosion flera negativa effekter på halvledarprodukter. Dishing minskar metallens effektiva tvärsnittsarea, vilket leder till högre sammankopplingsmotstånd och IR-fall, vilket i sin tur orsakar signalfördröjning och minskad tidsmarginal på kritiska vägar. Variationer i dielektrisk tjocklek orsakad av erosion förändrar den parasitiska kapacitansen mellan metalllinjer och fördelningen av RC-fördröjning, vilket undergräver enhetligheten hos elektriska egenskaper över chipet. Dessutom påverkar lokal dielektrisk förtunning och elektrisk fältkoncentration nedbrytningsbeteendet och den långsiktiga tillförlitligheten hos intermetalliska dielektriska komponenter. På integrationsnivån ökar överdriven yttopografi svårigheten med litografisk fokusering och inriktning, försämrar enhetligheten i efterföljande filmavsättning och etsning och kan inducera defekter såsom metallrester. Dessa problem uppenbarar sig i slutändan som fluktuationer i avkastningen och ett krympande processfönster. Därför är det i praktisk ingenjörskonst nödvändigt att kontrollera spolning och erosion inom specificerade gränser genom layoutdensitetsutjämning, optimering avpolering slurarselektivitet och finjustering av CMP-processparametrar för att säkerställa planariteten hos sammankopplingsstrukturer, stabil elektrisk prestanda och robust tillverkning av stora volymer.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alla rättigheter reserverade.
Links | Sitemap | RSS | XML | Sekretesspolicy |
