QR-kod

Produkter
Kontakta oss


Fax
+86-579-87223657

E-post

Adress
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
I halvledare och FPD -panelskärmar är beredningen av tunna filmer en viktig process. Det finns många sätt att förbereda tunna filmer (TF, tunn film), följande två metoder är vanliga:
● CVD (Chemical Vapor Deposition)
● PVD (fysisk ångavsättning)
Bland dem är buffertskiktet/aktiva skiktet/isoleringsskiktet alla avsatta i maskinens kammare med PECVD.
● Använd speciella gaser: SiH4/NH3/N2O för avsättning av SiN- och Si/SiO2-filmer.
● Vissa CVD-maskiner behöver använda H2 för hydrering för att öka bärarrörligheten.
● NF3 är en rengöringsgas. I jämförelse: F2 är mycket giftig och växthuseffekten av SF6 är högre än för NF3.
I halvledarenhetsprocessen finns det fler typer av tunna filmer, utöver den vanliga SiO2/Si/sin, finns det också W, Ti/Tin, HFO2, SIC, etc.
Detta är också anledningen till att det finns många typer av föregångare för avancerade material som används i halvledarindustrin för att göra olika typer av tunna filmer.
1. Typer av CVD och några föregångarsgaser
2. Grundläggande mekanism för CVD och filmkvalitet
CVD är ett mycket allmänt koncept och kan delas upp i många typer. Vanliga är:
● Pekvd: Plasma Enhanced CVD
● LPCVD: Lågtryck CVD
● ALD: Atomic Layer Deposition
● MOCVD: Metall-organisk CVD
Under CVD-processen måste prekursorns kemiska bindningar brytas innan kemiska reaktioner.
Energin för att bryta kemiska bindningar kommer från värme, så kammartemperaturen kommer att vara relativt hög, vilket inte är vänligt för vissa processer, såsom substratglaset på panelen eller PI-materialet på den flexibla skärmen. Därför, genom att mata in annan energi (bilda plasma, etc.) för att minska processtemperaturen för att möta vissa processer som kräver temperatur, kommer den termiska budgeten också att minska.
Därför används PECVD-avsättning av A-Si: H/sin/poly-Si allmänt i FPD-displayindustrin. Vanliga CVD -föregångare och filmer:
Polykristallint kisel/enkristallint kisel SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
Steg för den grundläggande mekanismen för CVD:
1. Reaktionsprekursorgas kommer in i kammaren
2. Mellanprodukter producerade genom gasreaktion
3. Gasens mellanprodukter diffunderar till substratytan
4. Adsorberad på underlagsytan och diffus
5. Kemisk reaktion sker på substratytan, kärnbildning/öbildning/filmbildning
6. Biprodukter desorberas, vakuumpumpas bort och släpps ut efter att ha kommit in i skrubbern för behandling
Som nämnts tidigare innehåller hela processen flera steg som diffusion/adsorption/reaktion. Den övergripande filmbildningshastigheten påverkas av många faktorer, såsom temperatur/tryck/typ av reaktionsgas/typ av substrat. Diffusion har en diffusionsmodell för förutsägelse, adsorption har en adsorptionsteori och kemisk reaktion har en reaktionskinetikteori.
I hela processen bestämmer det långsammaste steget hela reaktionshastigheten. Detta är mycket likt den kritiska vägmetoden för projektledning. Det längsta aktivitetsflödet avgör den kortaste projekttiden. Varaktigheten kan förkortas genom att allokera resurser för att minska tiden för denna väg. På liknande sätt kan CVD hitta den viktigaste flaskhalsen som begränsar filmbildningshastigheten genom att förstå hela processen och justera parameterinställningarna för att uppnå den ideala filmbildningshastigheten.
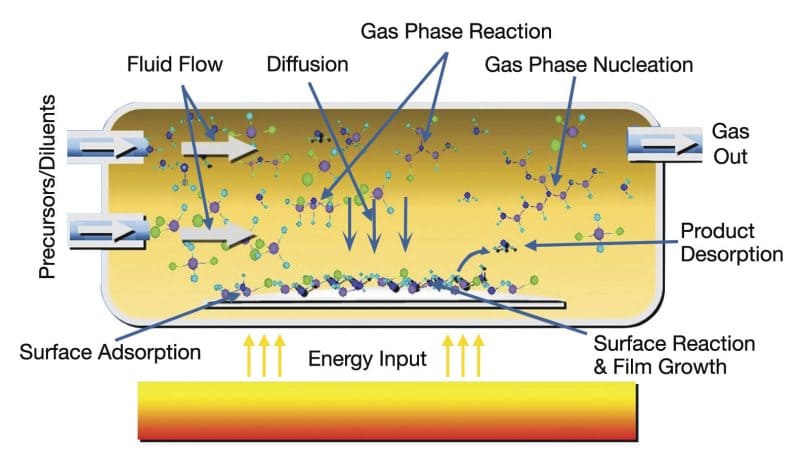
Vissa filmer är platta, andra är hålfyllning, och andra är spårfyllning, med mycket olika funktioner. Kommersiella CVD -maskiner måste uppfylla grundläggande krav:
● Maskinens bearbetningskapacitet, deponeringshastighet
● Konsistens
● Gasfasreaktioner kan inte producera partiklar. Det är mycket viktigt att inte producera partiklar i gasfasen.
Några andra utvärderingskrav är följande:
● Bra stegtäckning
● Förmåga att fylla luckor med höga bildförhållande (konformalitet)
● Bra tjocklekslikformighet
● Hög renhet och densitet
● Hög grad av strukturell perfektion med låg filmstress
● Bra elektriska egenskaper
● Utmärkt vidhäftning till underlagsmaterialet



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alla rättigheter reserverade.
Links | Sitemap | RSS | XML | Sekretesspolicy |
