QR-kod

Produkter
Kontakta oss


Fax
+86-579-87223657

E-post

Adress
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Kiselepitaxiär en avgörande grundläggande process i modern halvledartillverkning. Det hänvisar till processen att odla ett eller flera lager av tunna filmer av enkristallkisel med specifik kristallstruktur, tjocklek, dopningskoncentration och typ på ett exakt polerat enkristallkiselsubstrat. Denna odlade film kallas ett epitaxiellt lager (Epitaxial Layer eller Epi Layer), och en kiselskiva med ett epitaxiellt lager kallas en epitaxiell kiselskiva. Dess kärnegenskaper är att det nytillväxta epitaxiella kiselskiktet är en fortsättning på substratgitterstrukturen i kristallografi, vilket bibehåller samma kristallorientering som substratet, vilket bildar en perfekt enkelkristallstruktur. Detta gör det möjligt för det epitaxiella lagret att ha exakt utformade elektriska egenskaper som skiljer sig från substratets, vilket ger en grund för tillverkning av högpresterande halvledarenheter.
![]()
Vertial epitaxiell susceptor för kiselepitaxi
1) Definition: Kiselepitaxi är en teknologi som avsätter kiselatomer på ett enkristalliserat kiselsubstrat med kemiska eller fysikaliska metoder och arrangerar dem enligt substratets gitterstruktur för att skapa en ny tunn film av enkristallkisel.
2) Gittermatchning: Kärnfunktionen är ordningen i epitaxiell tillväxt. De avsatta kiselatomerna staplas inte slumpmässigt, utan är ordnade enligt kristallorienteringen av substratet under ledning av den "mall" som tillhandahålls av atomerna på ytan av substratet, vilket uppnår exakt replikering på atomnivå. Detta säkerställer att det epitaxiella skiktet är en enkristall av hög kvalitet, snarare än polykristallint eller amorft.
3) Styrbarhet: Kiselepitaxiprocessen tillåter exakt kontroll av tillväxtskiktets tjocklek (från nanometer till mikrometer), dopningstypen (N-typ eller P-typ) och dopningskoncentrationen. Detta gör att regioner med olika elektriska egenskaper kan bildas på samma kiselskiva, vilket är nyckeln till att tillverka komplexa integrerade kretsar.
4) Gränssnittsegenskaper: En gränsyta bildas mellan det epitaxiella lagret och substratet. Helst är detta gränssnitt atomärt platt och kontamineringsfritt. Kvaliteten på gränssnittet är dock avgörande för prestandan hos det epitaxiella lagret, och eventuella defekter eller kontaminering kan påverka enhetens slutliga prestanda.
Epitaxiell tillväxt av kisel beror huvudsakligen på att tillhandahålla rätt energi och miljö för kiselatomer att migrera på ytan av substratet och hitta den lägsta energigitterpositionen för kombination. Den mest använda tekniken för närvarande är Chemical Vapor Deposition (CVD).
Kemisk ångavsättning (CVD): Detta är den vanliga metoden för att uppnå kiselepitaxi. Dess grundläggande principer är:
● Prekursortransport: Gas som innehåller kiselelement (prekursor), såsom silan (SiH4), diklorsilan (SiH2Cl2) eller triklorsilan (SiHCl3), och dopningsgas (såsom fosfin PH3 för dopning av N-typ och diboran B2H6 för dopning av P-typ) blandas i kammarreaktion med hög temperatur och passerar in i en kammarreaktion med hög temperatur.
● Ytreaktion: Vid höga temperaturer (vanligtvis mellan 900°C och 1200°C) genomgår dessa gaser kemisk nedbrytning eller reaktion på ytan av det uppvärmda kiselsubstratet. Till exempel SiH4→Si(fast)+2H2(gas).
● Ytmigration och kärnbildning: Kiselatomerna som produceras genom sönderdelning adsorberas till substratytan och migrerar på ytan, och hittar så småningom rätt gitterställe att kombinera och börja bilda en ny singelkristallskikt. Kvaliteten på epitaxiell tillväxtkisel beror till stor del på kontrollen av detta steg.
● Skiktad tillväxt: Det nyligen avsatta atomskiktet upprepar kontinuerligt substratets gitterstruktur, växer skikt för skikt och bildar ett epitaxiellt kiselskikt med en specifik tjocklek.
Nyckelprocessparametrar: Kvaliteten på kiselepitaxiprocessen är strikt kontrollerad, och nyckelparametrarna inkluderar:
● Temperatur: påverkar reaktionshastigheten, ytrörligheten och defektbildningen.
● Tryck: påverkar gastransport och reaktionsväg.
● Gasflöde och förhållande: bestämmer tillväxthastigheten och dopningskoncentrationen.
● Underlagets yta rengörs: Alla föroreningar kan vara orsaken till defekter.
● Andra tekniker: Även om CVD är mainstream, kan teknologier som Molecular Beam Epitaxy (MBE) också användas för kiselepitaxi, speciellt i FoU eller speciella applikationer som kräver extremt hög precisionskontroll.MBE förångar kiselkällor direkt i en miljö med ultrahögt vakuum, och atomära eller molekylära strålar projiceras direkt på substratet för tillväxt.
Kiselepitaxiteknik har avsevärt utökat applikationsområdet för kiselmaterial och är en oumbärlig del av tillverkningen av många avancerade halvledarenheter.
● CMOS-teknik: I högpresterande logiska chips (som CPU:er och GPU:er) odlas ofta ett lågdopat (P− eller N−) epitaxiellt kiselskikt på ett kraftigt dopat (P+ eller N+) substrat. Denna epitaxiella kiselwaferstruktur kan effektivt undertrycka latch-up-effekten (Latch-up), förbättra enhetens tillförlitlighet och bibehålla substratets låga resistans, vilket bidrar till strömledning och värmeavledning.
● Bipolära transistorer (BJT) och BiCMOS: I dessa enheter används kiselepitaxi för att noggrant konstruera strukturer såsom bas- eller kollektorregionen, och transistorns förstärkning, hastighet och andra egenskaper optimeras genom att kontrollera dopningskoncentrationen och tjockleken på det epitaxiella lagret.
● Bildsensor (CIS): I vissa bildsensorapplikationer kan epitaxiella kiselskivor förbättra den elektriska isoleringen av pixlar, minska överhörning och optimera den fotoelektriska konverteringseffektiviteten. Det epitaxiella lagret ger ett renare och mindre defekt aktivt område.
● Avancerade processnoder: När enhetens storlek fortsätter att krympa blir kraven på materialegenskaper högre och högre. Kiselepitaxiteknologi, inklusive selektiv epitaxiell tillväxt (SEG), används för att odla ansträngda kisel- eller kiselgermaniumskikt (SiGe) i specifika områden för att förbättra bärarmobiliteten och därmed öka hastigheten på transistorer.
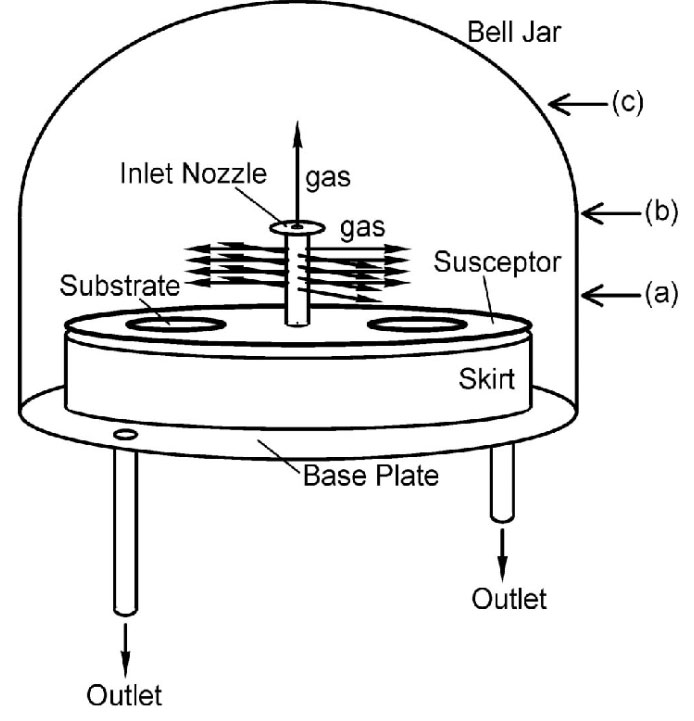
Horisontell epitaxiell susceptor för kiselepitaxi
Även om kiselepitaxitekniken är mogen och allmänt använd, finns det fortfarande vissa utmaningar och problem i den epitaxiella tillväxten av kiselprocessen:
● Defektkontroll: Olika kristalldefekter såsom staplingsfel, dislokationer, glidlinjer etc. kan genereras under epitaxiell tillväxt. Dessa defekter kan allvarligt påverka enhetens elektriska prestanda, tillförlitlighet och kapacitet. Att kontrollera defekter kräver en extremt ren miljö, optimerade processparametrar och högkvalitativa substrat.
● Enhetlighet: Att uppnå perfekt likformighet av epitaxiella lagertjocklek och dopningskoncentration på stora kiselskivor (som 300 mm) är en pågående utmaning. Olikformighet kan leda till skillnader i enhetens prestanda på samma wafer.
● Autodoping: Under den epitaxiella tillväxtprocessen kan högkoncentrationsdopningsmedel i substratet komma in i det växande epitaxialskiktet genom gasfasdiffusion eller diffusion i fast tillstånd, vilket gör att dopningskoncentrationen för epitaxialskiktet avviker från det förväntade värdet, särskilt nära gränsytan mellan det epitaxiella skiktet och substratet. Detta är en av de frågor som måste åtgärdas i kiselepitaxiprocessen.
● Ytmorfologi: Ytan på det epitaxiella lagret måste förbli mycket plan, och eventuella ojämnheter eller ytdefekter (som grumling) kommer att påverka efterföljande processer som litografi.
● Kosta: Jämfört med vanliga polerade kiselskivor, tillför produktionen av epitaxiella kiselskivor ytterligare processsteg och investeringar i utrustning, vilket resulterar i högre kostnader.
● Utmaningar med selektiv epitaxi: I avancerade processer ställer selektiv epitaxiell tillväxt (tillväxt endast i specifika områden) högre krav på processkontroll, såsom selektivitet av tillväxthastighet, kontroll av lateral överväxt, etc.
Som en nyckel halvledarmaterial beredningsteknik, kärnan ikiselepitaxiär förmågan att exakt odla högkvalitativa epitaxiella kiselskikt av enkristall med specifika elektriska och fysikaliska egenskaper på enkristallkiselsubstrat. Genom exakt styrning av parametrar som temperatur, tryck och luftflöde i kiselepitaxiprocessen kan skikttjockleken och dopningsfördelningen anpassas för att möta behoven hos olika halvledarapplikationer som CMOS, kraftenheter och sensorer.
Även om epitaxiell tillväxt av kisel står inför utmaningar som kontroll av defekter, enhetlighet, självdopning och kostnad, är kiselepitaxi fortfarande en av de viktigaste drivkrafterna för att främja prestandaförbättringar och funktionell innovation av halvledarenheter, och dess position inom tillverkning av epitaxiella kiselwafer är irreplaceable.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alla rättigheter reserverade.
Links | Sitemap | RSS | XML | Sekretesspolicy |
